BGA umožňuje vysokou hustotu a efektivní využití desky s plošnými spoji (PCB) díky tomu, že celá spodní strana čipu může být použita pro připojení, na rozdíl od mikropájených vodičů nebo quad flat packu (QFP), kde jsou připojení prováděna pouze po obvodu čipu. Pájecí kuličky navíc poskytují kratší spojení, která snižují indukčnost signálu, což má za následek menší šumové napětí a tím i lepší výkon. Aby bylo BGA správně pájeno, je třeba aplikovat přesné množství tepla, aby se každá kulička v mřížce adekvátně roztavila a tím bylo dosaženo kvalitního spojení. Cílem kontroly BGA je detekovat a izolovat vady, které vznikly během výrobního procesu, jako jsou dutiny nebo špatně pájené kuličky, a odhalit jejich příčiny.
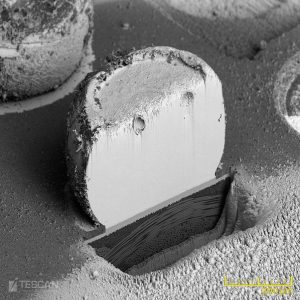
Průřez pájecí kuličky o průměru 400 μm, dokončený za 4 hodiny pomocí kombinace Xe Plasma FIBu a naklápěcího stolku pro hladký povrch řezu.
- Systémy TESCAN nabízejí širokou škálu možností pro kontrolu a analýzu poruch BGA.
- Detektor TESCAN BSE poskytuje vysoký kontrast, díky kterému jsou jasně viditelné intermetalické sloučeniny a vrstvy metalurgie pod pájecí kuličkou. Kontrola a charakterizace spojů pájecí kuličky v BGA jsou zásadní úkoly pro stanovení spolehlivosti integrovaného obvodu připojeného k desce plošných spojů a jsou rozhodující při určování kvality procesu pájení a při identifikaci příčiny poruchy.
- Plazmové systémy TESCAN FIB-SEM umožňují bez námahy vytvořit průřez pájecích kuliček, které mohou mít průměr až v řádech stovek mikronů, v bezkonkurenčně krátkém čase.
- Kromě toho je díky ultravysokým rychlostem oprašování materiálu, které může nabídnout pouze Xe Plasma FIB, možná 3D mikroanalýza (3D EDX, 3D EBSD) celých pájecích kuliček pro odhalení dutin, křehkých zlomenin, šíření prasklin v čipu nebo dendritických struktur.
- Detailní snímek kontrastu na hranicích zrn v metalických vrstvách pod pájecí kuličkou
- Průřez pájecí koulí, vytvořený a vyleštěný ze strany desky
- Průřez pájecí koulí, vytvořený a vyleštěný ze strany desky
- BSE obrázek průřezu pájecí koule zobrazující intermetalické sloučeniny mezi pájkou a kovovou podložkou, polyimidovou pasivaci a vrstvy integrovaného obvodu
- Detail struktury pod pájecí kuličkou
- Pájecí kuličky, přehledový snímek
- Průřez pájecí kuličkou o průměru 400 μm, dokončený za 4 hodiny pomocí Xe Plasma FIBu v kombinaci s naklápěcím stolkem pro docílení řezu bez artefaktů